关键词 |
烧结导电银胶,低温烧结纳米银膏,功率半导体烧结银,纳米银膏 |
面向地区 |
全国 |
粘合材料类型 |
电子元件 |
在众多封装技术中,倒装芯片技术的应用需求越来越广泛,随之而来的是对底部填充材料提出了更高的要求,既要确保保护盖或强化件与基材的良好粘合,又要减少芯片和封装体在热负荷下会发生翘曲的影响。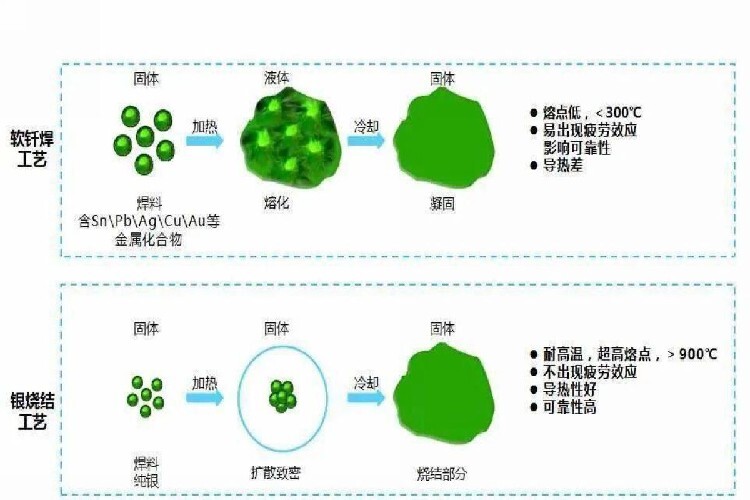
SHAREX善仁新材推出用于功率IC和分立器件以满足更高散热需求的半烧结芯片粘接胶 AS9330,导热率可以达到130瓦以上。
随着技术的进步,如今人们仅需一个平板电脑,甚至一部智能手机便能实现虚拟现实场景,不再需要复杂的采集设备及高成本的数据处理。实现这项技术的关键在于3D TOF传感器摄像头模组。
不同于普通的摄像头模组,3D摄像头拥有更多新增元器件:比如激光发射器、衍射光学元件而且模组实际体积往往更小于主流摄像头。此外3D摄像头模组的激光器控制芯片会在很小的面积上产生很大的热量。这就需要高导热,高可靠性的芯片粘接胶。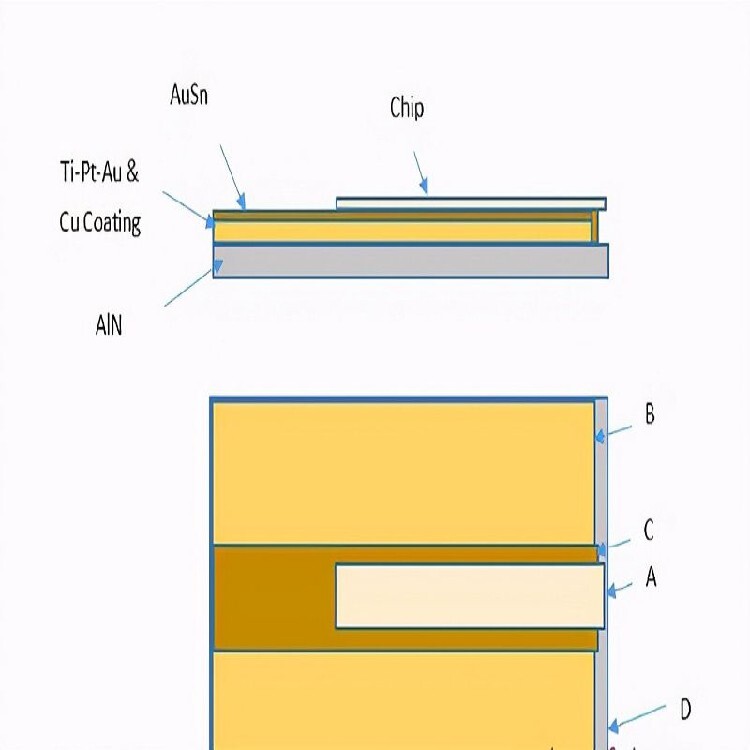
善仁新材在创新粘合剂技术方面拥有近20年的经验。凭借创新理念、技术,帮助客户解决挑战性的难题,并积极为不同行业的客户持续创造更值。
高导热率:导热率可达2700W/mK以上;高导电率:体阻低至2*10-6;耐候性好:-55-220°C; 和其他焊接工艺相比,可提高功率密度,降低系统总成本
