关键词 |
加压烧结银,烧结银,加压烧结银膏,SHAREX烧结银膏 |
面向地区 |
全国 |
粘合材料类型 |
电子元件 |
现有的银烧结技术得到的连接层,其内部空洞一般在微米或者亚微米级别,善仁新材的烧结银无论是有压烧结银还是无压烧结银都没有空洞。
随着第三代半导体器件(如碳化硅和氮化镓等)越来越多的应用在更加高温、高压和高频的环境,相应的封装材料和结构,尤其是芯片-基板的互连,在导热、导电和可靠性方面提出了更为严苛的要求。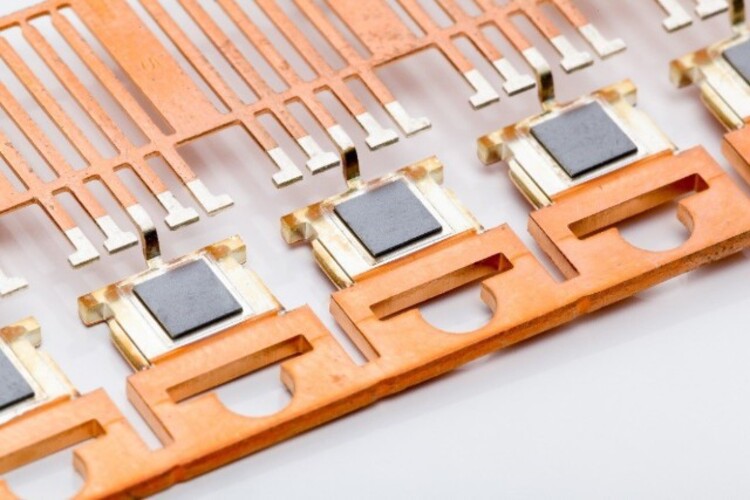
相比于传统的焊锡合金和导电银胶等互连材料,善仁新材的有压低温烧结银焊膏AS9385的电导率和热导率可提升3倍,可靠性可提升5倍,并且烧结银熔点为961 ℃,理论上可以在<700 ℃的高温环境下可靠工作,可以满足高温、高功率密度的可靠封装应用需求,得到了越来越广泛的研究和应用。
