关键词 |
加压烧结银膏,有压纳米烧结银,低孔隙率烧结银膏,高可靠烧结银 |
面向地区 |
全国 |
粘合材料类型 |
金属类 |
随着新一代IGBT芯片及功率密度的进一步提高,对功率电子模块及其封装工艺要求也越来越高,特别是芯片与基板的互连技术很大程度上决定了功率模块的寿命和可靠性。
传统钎焊料熔点低、导热性差,难以满足高功率器件封装及其高温应用要求。此外随着第三代半导体器件(如碳化硅和氮化镓等)的快速发展,对封装的性能方面提出了更为严苛的要求。AS9385有压银烧结技术是一种新型的高可靠性连接技术,在功率模块封装中的应用受到越来越多的关注。
银烧结是一种经过验证的芯片粘接技术,可确保无空隙和高强度键合,并具有高导热性和导电性。 这种有压烧结银AS9385技术良品率高,十分可靠。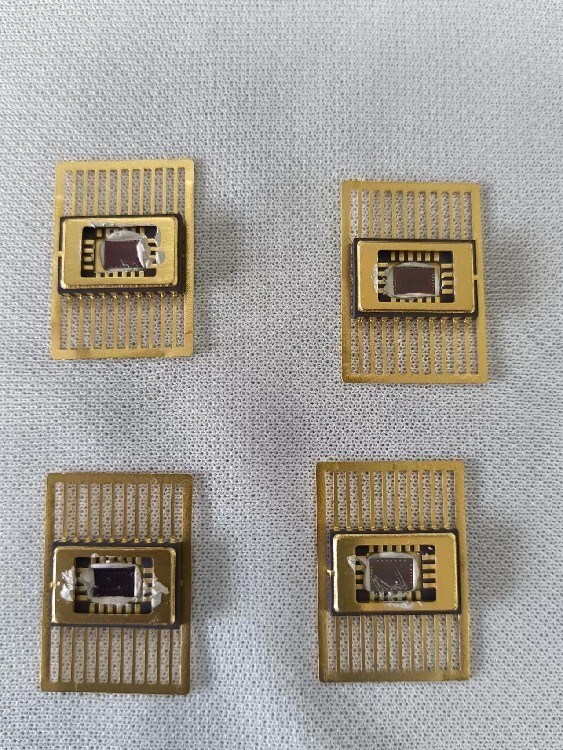
有压银烧结AS9385是一种新型的高可靠芯片粘接和键合技术,可确保无空隙和高强度键合,并具有的导热性和导电性。 该技术可以将器件的结温 (Tj) 低降至150℃。
相对于焊料合金,银烧结技术可以更有效的提高大功率硅基IGBT模块的工作环境温度及使用寿命。目前,AS9385银烧结技术已受到高温功率电子领域的广泛关注,它特别适合作为高温SiC器件等宽禁带半导体功率模块的芯片互连界面材料。
芯片转印是指将芯片在银膜上压一下,利用芯片锐利的边缘,在银膜上切出一个相同面积的银膜并粘连到芯片背面。

全国加压烧结银膏AS9385热销信息