关键词 |
SiC碳化硅烧结银膏 |
面向地区 |
全国 |
粘合材料类型 |
金属类 |
由于现有封装技术的限制,特别是芯片与基板的互连技术,例如银浆、聚合物材料,软钎焊等互连技术由于焊料合金的低熔点、环氧树脂的低温分解等原因,使其不能在高温环境下可靠工作,导致限制电力电子系统性能和可靠性的瓶颈从半导体芯片转移到了封装技术上来。
近年来以善仁新材开发的纳米烧结银技术为代表的低温连接技术是目前功率器件朝耐高温、高可靠性应用发展的主要趋势,其基本原理是利用纳米尺度下金属颗粒的高表面能、低熔点特性来实现芯片与基板的低温低压烧结互连。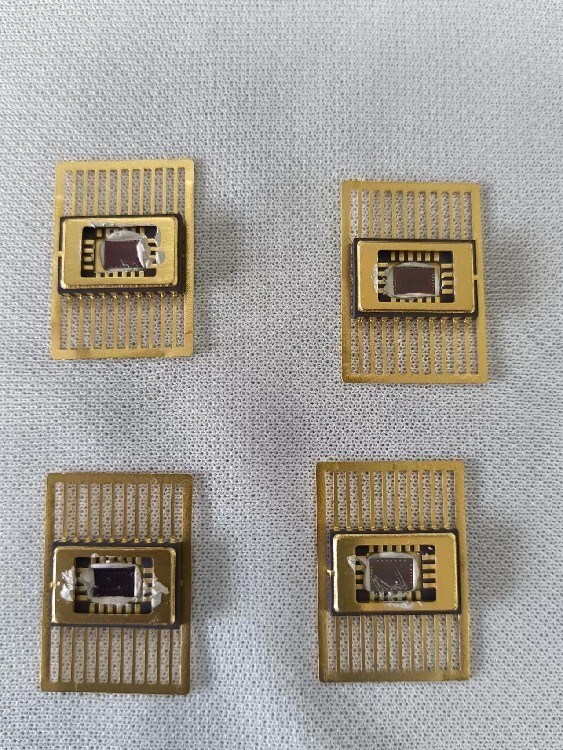
善仁新材纳米烧结银互连结构成型原理及微观结构
纳米颗粒具有特的性能,其比表面积小并且表面曲率半径小,这种特性赋予了它具有比常规的粉体更低的熔点和焊接温度。根据善仁新材研究院的经验得知:纳米银在粒径尺度在10nm以下时,它的烧结温度能降低到100℃以下,比块状时候的熔点的961℃低了800℃以上。与块状银微观结构不同是,纳米烧结银互连层是属于微孔材料,即在其内部分布有众多的微孔隙,微孔隙的尺寸位于亚微米至微米范围间。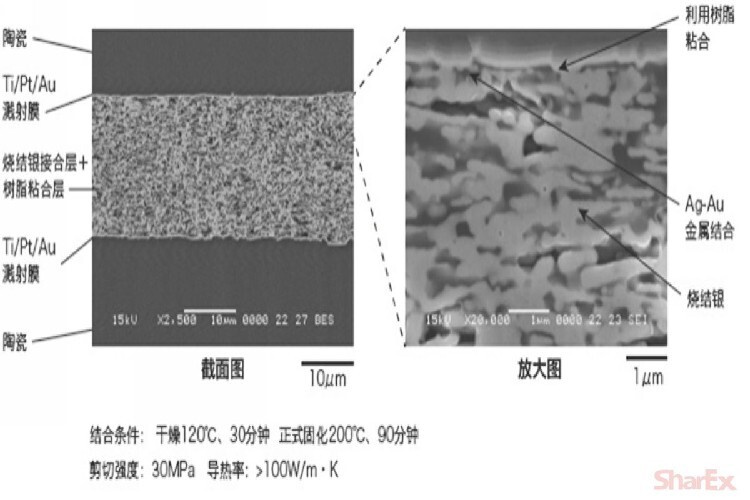
善仁新材另外发现在烧结工艺中引入超声振动能够提高烧结银尺寸和密度,并发现其在处理烧结不充分的边缘地方,能减小过度区,提高纳米烧结银互连层的连接强度;通过引用脉冲电流影响烧结工艺,能够在3分钟的快速烧结中,得到剪切强度为30-35MPa的工艺方法。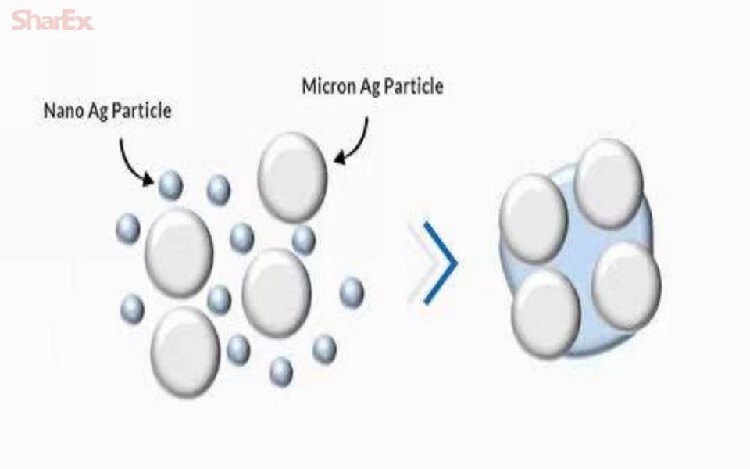
纳米烧结银互连层的孔隙研究
善仁公司统计了在不同时间和温度下孔隙率情况。发现孔隙率的大小和芯片的大小有很大的关系,采用无压纳米烧结银AS9375封装5*5mm的小芯片,几乎无孔隙。对于大于5*5mm的芯片,空隙率会在3-8%之间。孔隙主要由小孔和中孔组成,在250℃烧结时,空隙会很少。
随着无铅化的推进,善仁新材的纳米烧结银时替代焊锡膏作为连接材料的候选材料之一,特别是在混动和电动汽车,高铁,航空航天,太阳能,深井石油开采等需要在200度恶劣环境下的各种工作应用,必将成为主流的互连材料之一。
