关键词 |
加压烧结银,加压烧结银膏,善仁烧结银,烧结银 |
面向地区 |
全国 |
粘合材料类型 |
电子元件 |
由于传统锡膏和金锡焊片存在着天然的不足:锡膏不环保,导热系数差,耐回流效果差等问题;金锡焊片存在着导热系数差,价格昂贵等问题。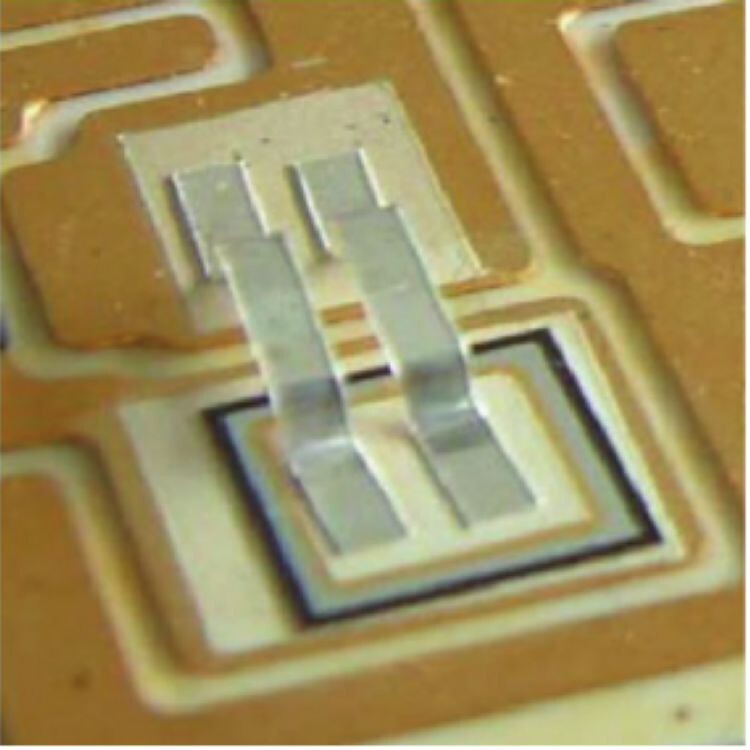
基于以上两款焊料的不足,有压烧结银AS9385应运而生,烧结银克服了以上两款产品的各种不足和问题,具有导热系数高,剪切强度大,生产,无铅化、免清洗等特点,是第三代半导体封装的理想焊接材料。
银烧结技术具有方面的成本效益,包括高吞吐量、低成本、高良率和低人工成本等。时至今日,已经有不少厂商提供采用银烧结技术制造的功率模块,
现有的基板铜层的贵金属镀层也增加了成本;散热新材开发的 AS9385有压纳米烧结银可以焊接裸铜,大大降低了客户的生产成本;
现有的银烧结技术需要一定的辅助压力,高辅助压力易造成芯片的损伤;善仁新材的有压烧结银AS9375可以无压烧结;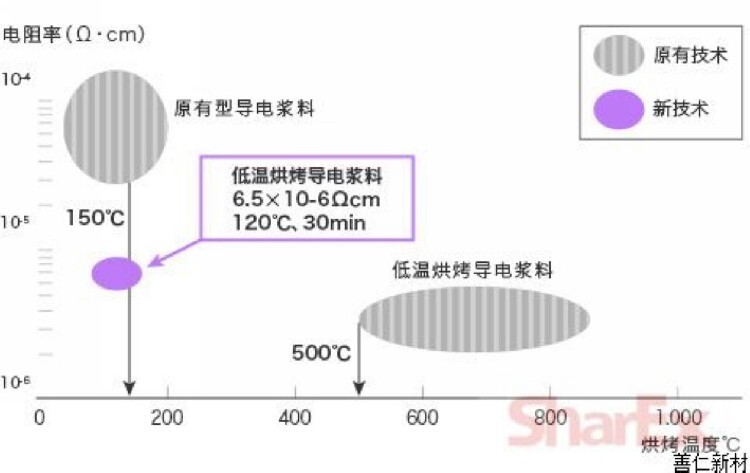
相比于传统的焊锡合金和导电银胶等互连材料,善仁新材的有压低温烧结银焊膏AS9385的电导率和热导率可提升3倍,可靠性可提升5倍,并且烧结银熔点为961 ℃,理论上可以在<700 ℃的高温环境下可靠工作,可以满足高温、高功率密度的可靠封装应用需求,得到了越来越广泛的研究和应用。
